2020年大學生數學建模A題:爐溫曲線
前言
比賽完第一天就開始著手寫這篇文章,思維可能有點侷限性,如果有更好的思路和想法可以評論出來,一起討論學習。
完整所有的題目下載(無需積分):2020數學建模賽題
題目整理:
同時已經對該題目給出如下的分析和整理
- 黃色代表:題目已給出的條件
- 紫色代表:需要注意考慮的點
- 藍色代表:需要解決的問題

題目分析
作為工科生,尤其是專業就是學習這方面,一看題目就能快速理解回焊爐的整體工作流程,並著手開始思考分析題目的問題和其中涉及的難點。
關於熱傳遞的三種基本方式:
-
熱傳導(傅立葉熱傳導方程)

-
熱對流(牛頓冷卻公式)

-
熱輻射

參考自:[SMT再流焊溫度場的建模與模擬_黃丙元]
PCB板基本材料特性

參考自:[PCB板熱特性分析與研究_鄧志勇]
問題一
思路一:
此時根據 [基於Ansys_Icepak的板級迴流焊接建模與模擬_姚煥] 論文給出的假設:
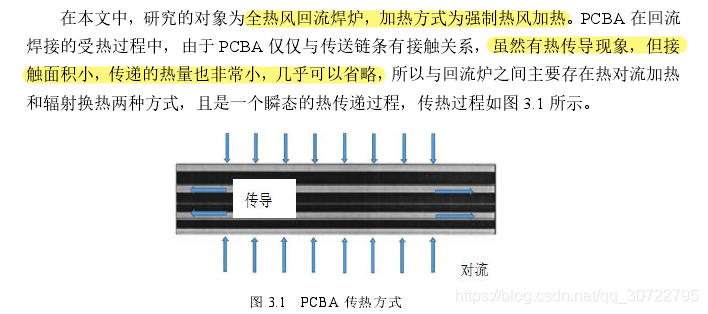
此時假設研究物件為全熱風迴流焊爐,只考慮熱對流和熱輻射兩種,忽略熱傳遞的計算,也就是不考慮中間的5cm間隔之間的熱傳導。
關鍵點:根據附件和溫區溫度,反推求出每個溫區的對流傳熱係數(hc)
-
先使用附件中的溫度時間變化曲線為條件,使用:
各溫區熱能 = 各溫區熱對流 + 各溫區熱輻射

列出公式反推出每個溫區的傳熱係數(hc)
-
此時各溫區的hc已知,利用
Q = 各溫區熱對流 + 各溫區熱輻射計算得出1-5小溫區、6小溫區、7小溫區、8-9小溫區的熱量;

-
將各溫區能量對各溫區的時間進行微分,求出當
t->0時,熱量的大小;

-
此時根據第一時刻溫度25℃,以
t=0.5進行積分,算出0.5s吸收的熱量,轉換為溫度;

-
寫一個遞迴函數,以第一時刻25℃為邊界起始條件,不斷進行遞迴,即可求出後面每隔0.5s的溫度值;
-
將所有對應的時間和溫度值使用MATLAB放入一個二維矩陣,然後通過
curve fitting擬合出來最終的方程式; -
根據將要求的對應溫區的中點時間計算得出;

-
將時間帶入擬合出來的方程即可得到每個對應中點的溫度值;

-
將時間和擬合方程式用
plot即可畫出爐溫曲線;
此時做出的曲線不出意外應該是直線那種,不過因為斜率不同,導致變化,但不平滑。
思路二:
即考慮每個小溫區間的5cm間隔
- 此時只需要在思路一的基礎上使用熱傳導方程;
- 因為能量總是由能量高的地方向能量低的方向流動;
- 使用熱傳導方程算出下一個小溫區向前一個小溫區的熱量即為5cm間隔的熱量;
- 把5cm這段時間內的熱量根據前一個溫區的末尾溫度為起始邊界條件,即可算出5cm間隔內每隔0.5s的溫度值;
問題二
- 根據第一問得出的各溫區傳熱係數、題目的製程界限和題目中的溫度,還有過爐速度的調節範圍為65~100,列出相應的約束條件;
MIN過爐速度為目標函數,建立相應的單目標最佳化數學模型,使用LINGO求得最優過爐速度;
問題三
思路一:
假設:
- 爐溫曲線超過217℃到峰值溫度所覆蓋的面積:
A
針對此問題,可以很明確知道這一問是多目標多優化的模型問題,我的想法如下:
- 使用控制變數法來求解;
- 同樣使用第二問的一些約束條件為基準;
- 先使用附錄和題目一、二問的各溫區溫度求平均做為該題設定的初始化溫度;
- 控制溫度先不變,然後使用二分法對回爐速度進行一個合理範圍的劃分和得出;
- 關鍵點:此時以覆蓋面積
A MIN最小為目標函數,反推求出每個溫區的設定範圍; - 此時因為回爐速度、各區間溫度都在很小的範圍內,計算量大大減小;
- 然後使用三重回圈迭代,求出面積最小時的回爐速度、各溫區的溫度。
思路二:
無腦暴力破解法
此方法計算量大,消耗時間,並不推薦。
此方法簡單,在回爐速度、各溫區溫度限定範圍內,以覆蓋面積A MIN最小為目標函數,一直跑的試,直到跑完後,比較得出相應最小面積下的的各溫區溫度和最佳鍋爐速度。
問題四
此問題,想法不多,但可以分享下:
- 假設出
t=開始高於217℃的瞬時的時間和t1=開始低於217℃的瞬時的時間; - 可以知道:溫度上升時的導數和下降時的導數相等即為曲線對稱;
- 所以從兩端
t和t1向中間(t+t1)/2的時間走,進行求導比較; - 此時應該可以繼續使用問題3的思路一進行求解了。
此問題,說是問題3的優化,也有那麼點感覺,但又沒什麼想法,反正蠻難受的。
參考文獻
1. 表面貼裝工藝生產線上迴流焊曲線的優化與控制_高金剛
2. SMT溫度場的數學模型_黃丙元
3. SMT再流焊溫度場的建模與模擬_黃丙元
4. PCB板熱特性分析與研究_鄧志勇
5. XX線路板表面貼裝焊接工藝研究_張疏影
6. 基於Ansys_Icepak的板級迴流焊接建模與模擬_姚煥
7. 牛頓冷卻定律及其實際應用_郭文傳
8. 基於加熱機理分析的迴流焊過程模擬建模與有限元分析_宋巍
9. 多層印刷電路板元件結構的熱_力分析_吳許傑
10.印製電路製程過程中互連區域的熱力學模擬研究_曾亮
結束
多多少少寫了一下午,大體提供一下我的想法和做題的思路,具體的程式碼論文也就不放了,菜雞文章,同時後期有什麼也會一直修改文章,希望大家多多評論思考呀!!!
如果有任何問題,歡迎留言糾正,秉著學習的態度,大家一起思考解決。☺